SIMS分析の基礎(1) SIMSとは?
SIMSとはどのような装置ですか?
SIMSについて
英語名称 Secondary Ion Mass Spectrometryの略称です。
日本語では、2次イオン質量分析法となります。
SIMSは、いわゆる表面分析法の一つで個体試料内の高感度元素分析を得意とする分析法となります。
機器による材料分析(元素分析)について
どこの、何を、知りたいか?
| 観察場所 | 形態観察 | 元素分析 | ||
|
|
|
||
|
表面近傍の不純物を知りたい ↓ 2次イオン質量分析法(SIMS) |
||||
表面分析法、および類似の手法
~光、荷電粒子と固体の相互利用した分析法
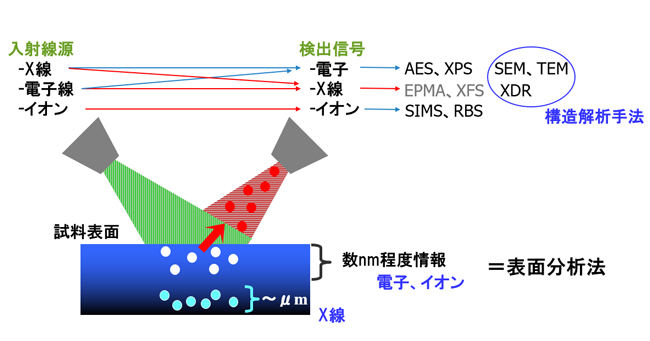
主な分析手法とその基礎になる物理現象
AES: オージェ電子分光法 ( Auger Electron Spectroscopy )
→ オージェ電子の検出 ( オージェ過程 、量子条件、原子軌道)
XPS: X線光電子分光法 (X-ray Photoelectron Spectroscopy)
→ 光電子の検出 ( 光電効果、量子条件、原子軌道)
EPMA: 電子線マイクロアナライザー (Electron Probe Micro Analyzer )
→ 電子線励起特性X線の検出 ( 特性X線、量子条件、原子軌道)
XFS: 蛍光X線分光法 (X-ray Fluorescence Spectroscopy)
→ X線励起特性X線の検出 ( 光電効果、量子条件、原子軌道)
SIMS: 2次イオン質量分析法 (Secondary Ion Mass Spectrometry)
→ 2次イオンの検出 ( スパッタリング、イオン化)
RBS: ラザフォード後方散乱分光法 (Rutherford Backscattering Spectrometry)
→ 散乱イオンの検出 (ラザフォード散乱)
SEM: 走査電子顕微鏡法 (Scanning Electron Microscopy)
→ 2次電子の検出 ( 反射電子、特性X線の利用)
TEM: 透過電子顕微鏡法 (Transmission Electron Microscopy)
透過電子の検出 (特性X線、EELSの利用)
基礎的な物理現象を利用している
オージェ電子と特性X線の関係、および光電子

SEM、TEMによる元素分析
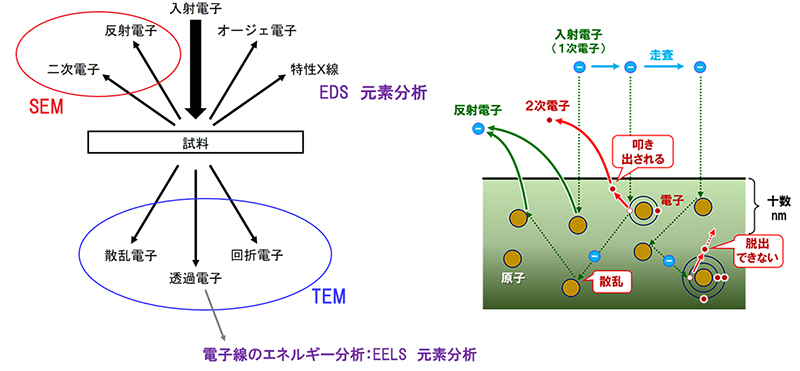
SIMS (二次イオン質量分析法)原理
Secondary Ion Mass Spectrometry
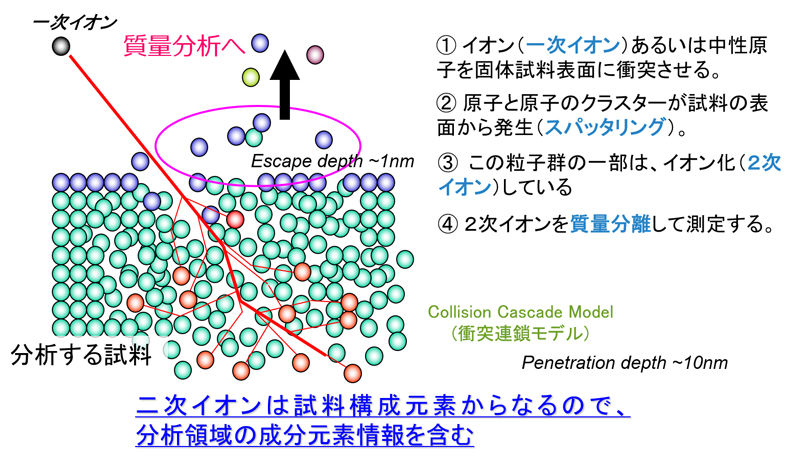
SIMS装置の種類 (質量分析計による違い)
セクター磁場SIMS(二重収束質量分析計)
(Double-focus Magnetic Sector)
高い質量分解能で深さ方向分析
検出下限が極めて低い・・・・<1014atoms/cm3
スループットが高い
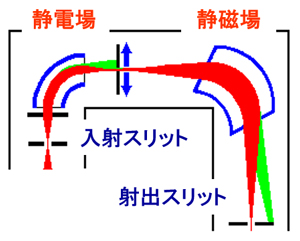
四重極SIMS(四重極質量分析計)
(Quadrupole Mass Analyzer)
2次イオン引込み電圧が<200Vと低く、
装置自由度が高い(低加速の1次イオン、
1次イオン入射角可変)
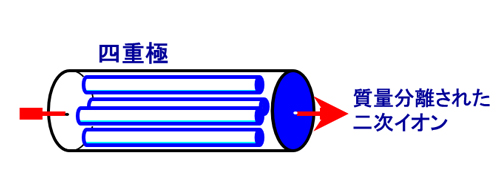
TOF-SIMS(飛行時間型質量分析計)
(TOF; Time of Flight)
質量分解能が高い
分析器の透過率が高い
10,000amu.以上の質量まで検出可能
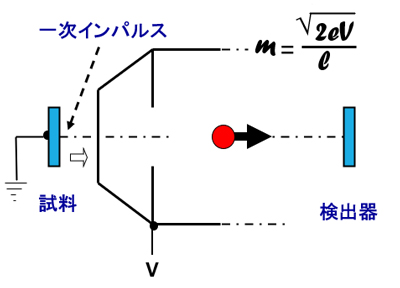
質量分析計の種類と特徴まとめ
(四重極質量分析計)
(二重収束質量分析計)
(飛行時間型質量分析計)
・一次イオン入射角が可変
・装置が比較的小型
・超高真空
・高質量分解能
・制限視野分析
・全質量ピークの同時検出
・思いイオン(m/z >1,000)の分析が可能
・感度不足(特にHigh Mass 領域)
・(半)絶縁物分析が苦手
・一次イオンビームの電圧低下が困難
・装置調整が難しい
・深さ方向の分析のスループットが低い
・MOS(Shallow)Junction
・イオン注入プロファイル
・(有機)汚染の評価
(・Shallow Depth Profile)
ToF-SIMSとD-SIMS(Dynamic SIMS)の違い
ToF-SIMS:1次イオンがパルス化されている ⇔ D-SIMS:1次イオンが連続ビーム
(1 pulse あたりの照射イオン量が少ない)
D-SIMS(カメカ社製セクターSIMS)の優位性
①連続ビームのため測定時間が短い
②大電流1次イオンによる高感度分析が可能
③高空間分解能と高質量分解能を同時に達成できる

ToF-SIMSとD-SIMSの使い分け
- ToF-SIMS :1pulseですべてのスペクトル取得可能(実際には積算が必要なので1pulseではない)
- D-SIMS:磁場の強度をスィープする必要がある(その間試料が削れる)
ToF-SIMS:マススペクトルの取得に有効 高分子材料(有機物)の分析に有効

D-SIMS:大電流で高感度、かつ短時間でデータ取得可能 デプス分析に有効
D-SIMS(セクター磁場型)の特徴
・高感度分析
ppm~ppbオーダの検出感度の分析が可能
・元素分析
水素をはじめ周期律表の全ての元素の分析が可能
→ 水素分析が可能な唯一の表面分析法
・深さ方向分析
元素の深さ方向分布測定が可能 (µmオーダからnmオーダの範囲)
・面内分析
二次イオン像から面内の元素分布を知ることが可能
・同位体分析
ミクロンオーダの領域での同位体比測定可能
シリコン中の各元素検出下限 (カメカ社セクターSIMS典型例)
Hも含めた周期律表にあるほとんどの元素は、ppmオーダーの検出下限で分析できる。
シリコンの原子密度は、5E22atoms/cm3 (5E16 = 1ppm, 5E13 = 1ppb)

D-SIMS装置の概念図
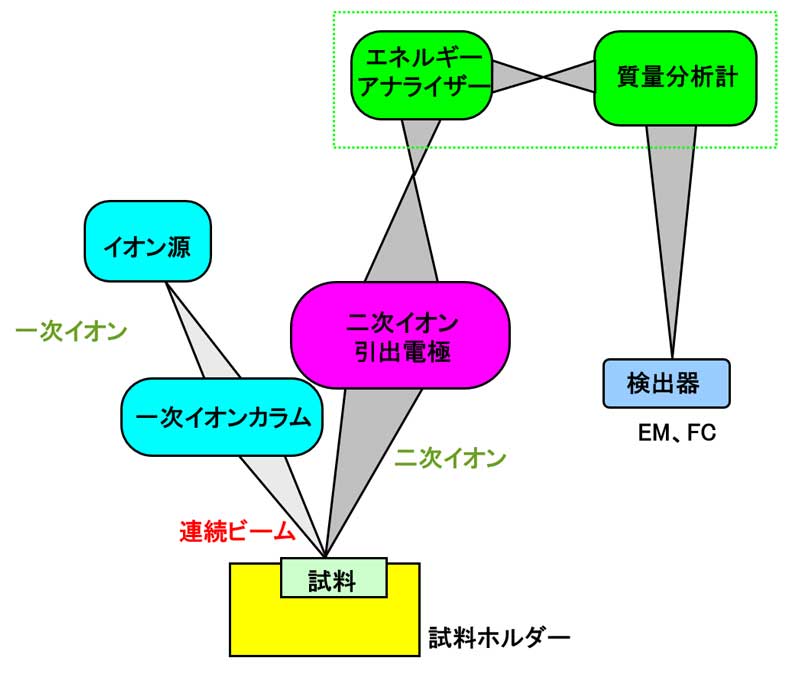
①イオン源にてイオンを発生させる
(D-SIMSでは、通常Cs+、またはO2+)
②発生したイオンを加速して試料に照射する
(1次イオンビーム光学系)
③1次イオン照射により2次イオンが発生する
(2次イオン)
④2次イオンを加速しエネルギー収束、質量分離を行う
(2次イオン光学系)
⑤2次イオンの量を検出器で計測する
実際の装置の構造(CAMECA ims-7f)
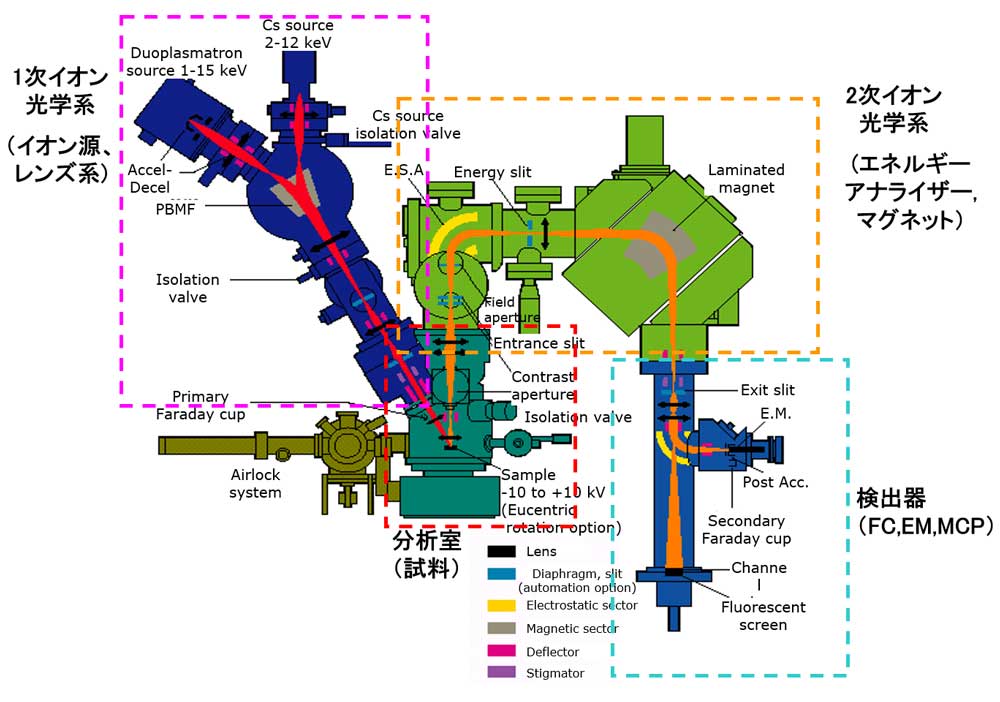
D-SIMSによる深さ方向分析

①元素Aのイオンが検出できるように磁場を設定
②一定時間Aイオン強度を計測し積算する
③元素Bのイオンが検出できるように磁場を設定
(磁場が安定すまで時間が必要)
④一定時間Bイオン強度を計測し積算する
⑤元素B→Cについても同様のことを行う
⑥元素C→A、 A→B 、 B→C・・・
と繰り返し同じ作業を行う
⑦図のようなプロットができる
↓
SIMSの生データは時間に対するイオン強度の変化である
生データから一般的なデータ(横軸=深さ、縦軸=濃度)への変換

測定時間⇒深さの変換
①1次イオンを試料の同一場所に照射し続けるとクレータが生じる
(底面が均一なクレータを作るためラスターされる)
②表面形状測定機などでクレータの深さを測る
③深さ方向に組成変化のない試料ならクレータの深さを測定時間で∝換算する
※多層膜の場合各膜ごとのスパッタレート比で換算する
(あるいは、膜厚が既知ならそれを利用する)
イオン強度⇒濃度の変換(1%以下の低濃度の場合)
①同じ母材で不純物濃度既知の試料(標準試料)を用意する
(低濃度領域ではイオン強度と濃度が正比例する)
②標準試料のイオン強度と濃度を比較して換算係数(k)を求める
(測定のばらつきを軽減するため母材のイオン強度との比を利用=相対感度係数)
Relative Sensitivity Factor = RSF
高濃度領域ではイオン強度と濃度が比例しない
カメカ社製SIMSによる高感度深さ分析例






















